使用虚拟实验设计加速半导体工艺发展
judy-- 周四, 04/13/2023 - 15:47
本文将说明我们在高深宽比通孔钨填充工艺中,利用虚拟DOE实现了对空隙的有效控制和消除。

本文将说明我们在高深宽比通孔钨填充工艺中,利用虚拟DOE实现了对空隙的有效控制和消除。
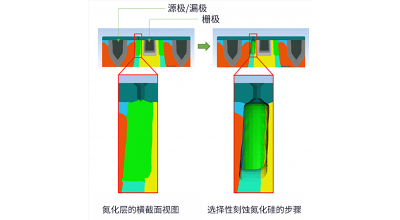
本文中,我们将专注于前道工序 (FEOL),并演示在栅极和源极/漏极之间引入空气间隙的SEMulator3D®模型

作者:Coventor(泛林集团旗下公司)半导体工艺与整合 (SPI) 高级工程师王青鹏博士